

Investigations of the hafnium and silicon core level spectra indicate the occurrence of silicon dioxide and hafnium silicide in the case the samples were produced at elevated temperatures. Planck constant I c integrated peak intensity in the GIXRD pattern of the. These facts suggest a chemical instability which is confirmed by X-ray Photoelectron Spectroscopy (XPS).
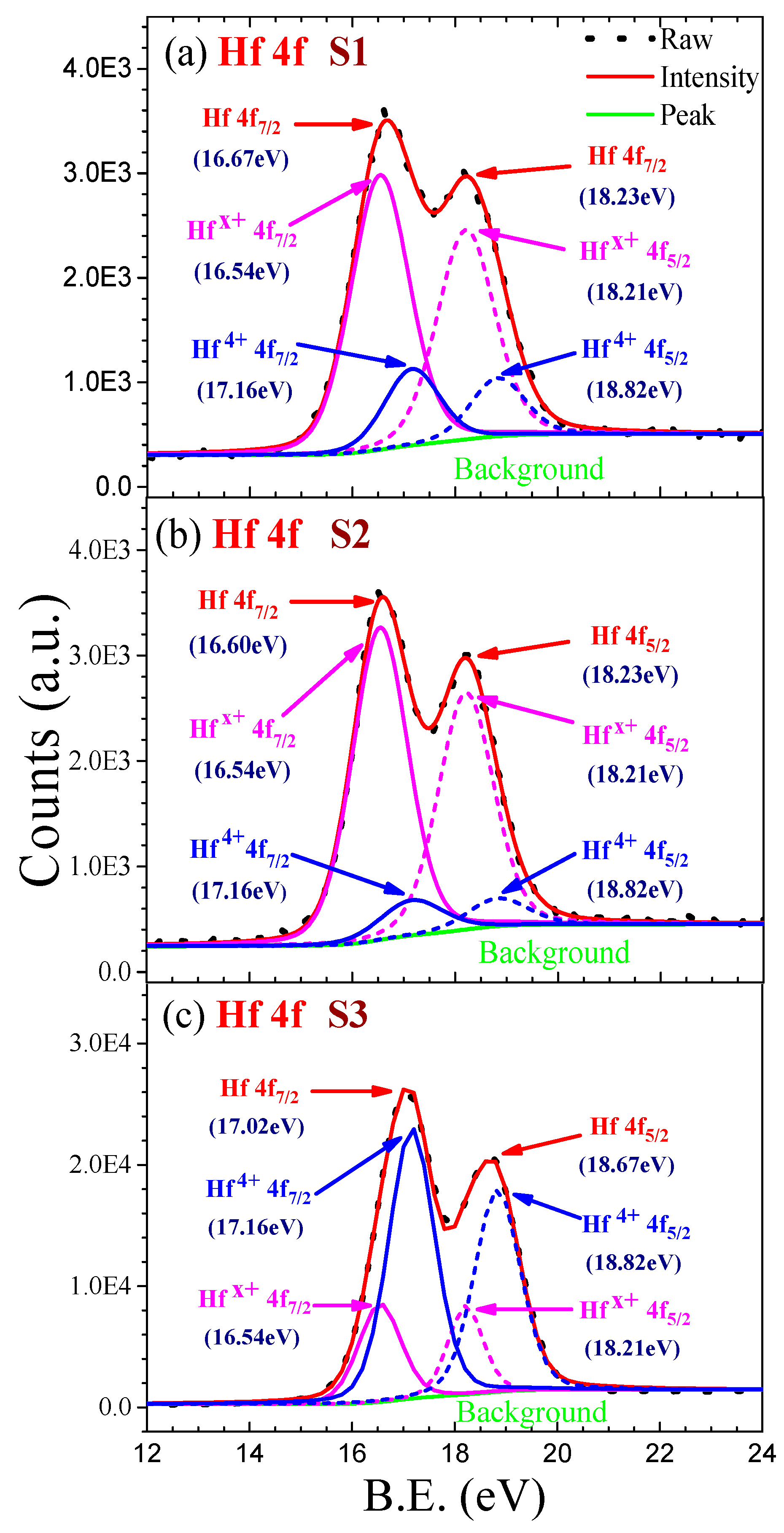
The energy scale was calibrated against the C 1s peak that was set at 285 eV. Atomic Force Microscopy (AFM) images show a clear transition from smooth layers consisting of small area crystallites to very rough surfaces characterized by large craters and regular, plane features when the growth temperature was increased. XPS analysis of the samples was performedex situby Kratos Ultra XPS spectrometers at 0° takeoff-angle with 0.5 eV step size for survey scans and 0.1 eV step size for high-resolution scans using an Al achromatic source, h 1486.6 eV. The influence of laser wavelength (fundamental, second and third harmonic of a Nd:YAG laser), used for evaporation, and substrate temperature on the film morphology, chemical structure and interfacial quality were investigated yielding the following results: While the laser wavelength exhibits minor influence on layer structure, the substrate temperature plays a critical role regarding morphological and chemical structure of the produced hafnium oxide / silicon stacks. Hafnium oxide films were prepared by Pulsed Laser Deposition (PLD). Hafnium(IV) oxide thin films were synthesized by atomic layer deposition (ALD) on Si(100) substrates, using an innovative guanidinate-stabilized hafnium amide precursor, Hf(NEtMe) 2 (EtMeNC(N i Pr) 2) 2.In the present work, our attention is focused on a detailed XPS characterization of a representative HfO 2 coating grown at 350 ☌.


 0 kommentar(er)
0 kommentar(er)
